- Home
- 受託試験サービス
- 信頼性評価試験、環境試験
- 信頼性評価試験
- 鉛フリー実装評価
信頼性評価試験、環境試験
鉛フリー実装評価: 鉛フリーはんだ基板実装評価をノウハウ等も含め豊富な技術で、環境試験のみならず、はんだ接合部の機械強度測定から断面観察まで一貫した評価を実施することが可能
鉛フリー実装評価
環境への関心が世界的に高まっている中、RoHSなど電子機器の環境対応により電子部品/電子製品の鉛フリー化への取り組みが、半導体業界および電子機器業界で広まりつつあります。鉛フリーはんだ接合部には、従来の鉛入りはんだと同等以上の信頼性が要求されています。一方、高密度実装化に伴い接合部の微細化がますます進み、接合信頼性の確保がさらに難しくなっています。実装基板の鉛フリー評価は、環境試験前後での外観観察、はんだ接合部の機械強度測定、断面観察、組成分析など総合的な評価が必要です。OKIエンジニアリングでは鉛フリーはんだ基板実装評価をノウハウ等も含め豊富な技術で、環境試験のみならず、はんだ接合部の機械強度測定から断面観察まで一貫した評価を実施することが可能です。また、部品レベルの評価では、端子のはんだぬれ性評価やICパッケージのリフロー試験も実施できます。
はんだぬれ性評価
はんだのぬれ(Wettinng)とは、 溶けたはんだが金属の上を広がる状態(固体に接触した液体が流れて広がっていくことを「ぬれ」)をいいます。
はんだのぬれ性は一般的に、はんだ・フラックス・金属(サンプル)の種類、金属の表面状態や、サンプルの熱容量等で変化します。
OKIエンジニアリングでは、各試験法によるゼロクロス時間やぬれ上がり時間の測定、試験後の外観観察による不ぬれやはんだはじき等の異常の確認に対応します。
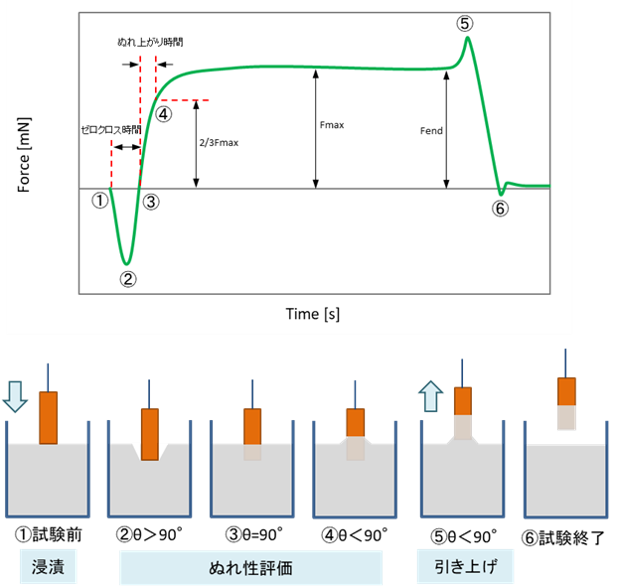
ぬれ曲線概略図
試験概要
- 各種前処理対応可
- 試験温度:~450℃
- フラックス、はんだ:条件に合わせて調整可
- はんだ槽平衡法
- はんだ小球平衡法(小球径:Φ4mm、2mm、1mm)
チップ部品は0402(ミリ)まで対応 - ソルダーペースト平衡法
急加熱昇温、プロファイル昇温法 - 試験時の動画撮影、試料の予熱可能(オプション)
対応規格
JIS規格/MIL規格/AEC-Q規格/J-STD-002
はんだ槽平衡法
溶融したはんだ槽に、フラックスを塗布したサンプルを浸漬させる試験です。サンプルとはんだの作用力を測定し、ゼロクロス時間やぬれ力の評価を行います。
比較的大きなサンプルでも対応可能であり、外観でのはんだ付け性を評価する際にもこの試験方法を採用することが多いです。
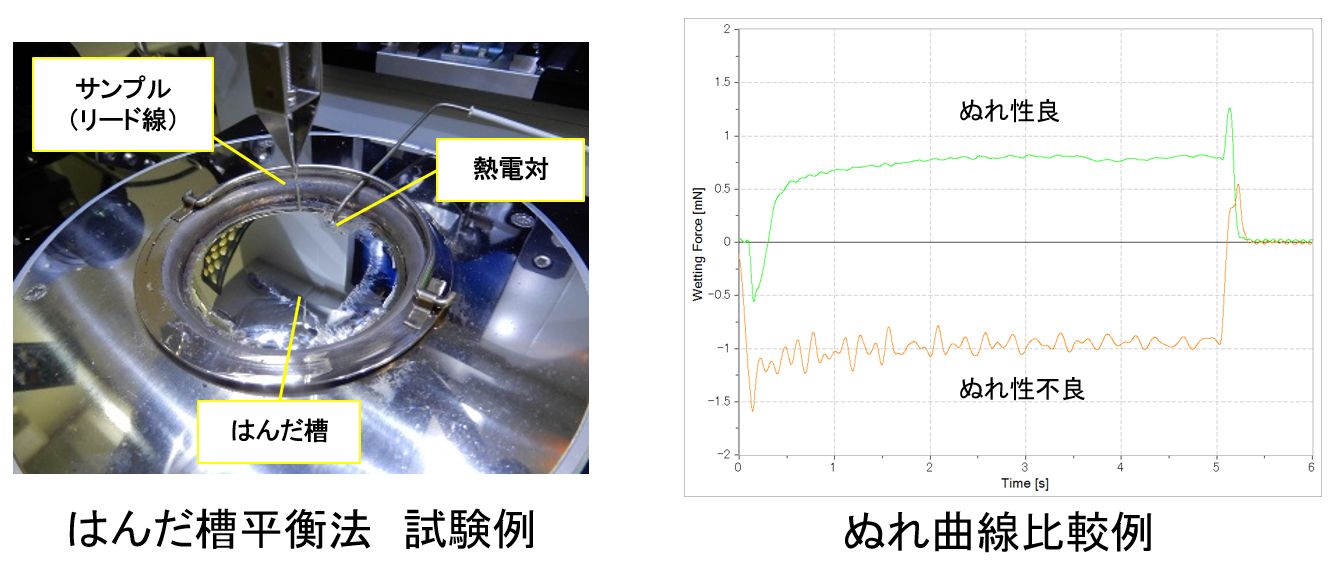
はんだ小球平衡法
はんだ槽では評価が困難な微小なサンプルに対し、溶融したはんだ小球に、フラックスを塗布したサンプルを接触させる試験です。はんだ槽平衡法同様に、作用力からぬれ性の評価を行います。
チップ部品は最小0402(ミリ)までの対応が可能です。また、試験時の動画撮影も対応しています。
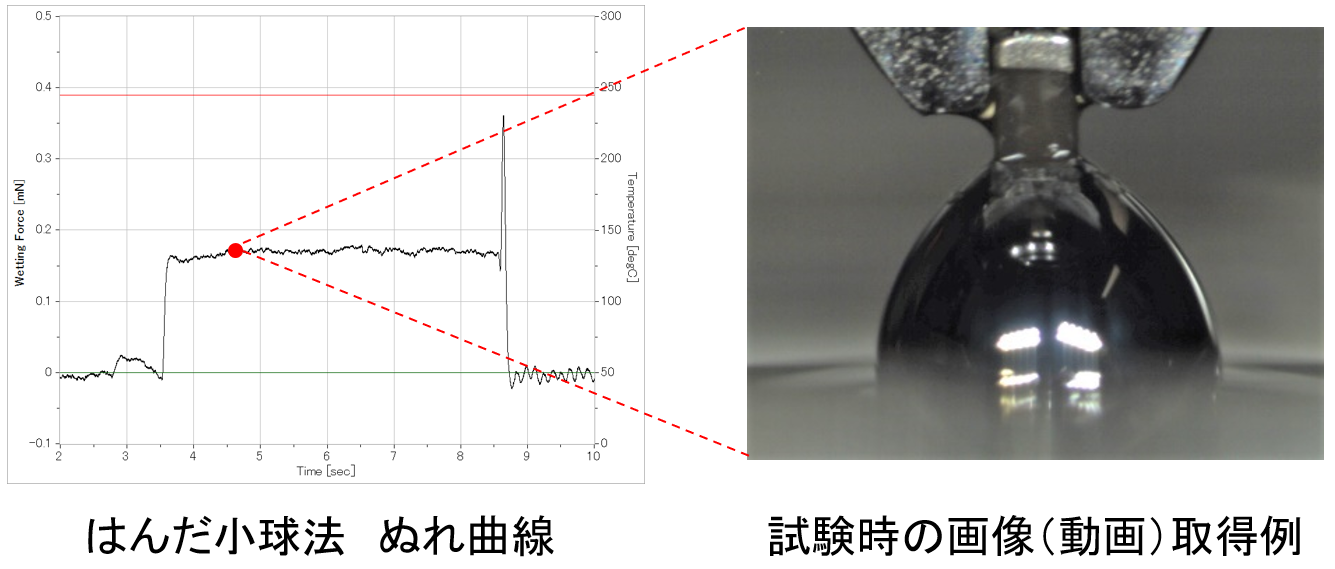
ソルダーペースト平衡法
表面実装型のサンプルを対象とし、実際に実装工程で使用するソルダーペーストを用いて実施する試験です。
サンプルを接触させたソルダーペーストを加熱することにより生じる作用力を測定し、はんだ槽平衡法同様に、作用力からぬれ性の評価を行います。
急加熱昇温法、プロファイル昇温法の対応が可能です。
はんだ接合強度評価
はんだ接合強度評価でのリード端子強度測定においてはJIS評価方法(JIS Z 3198)の規格化に大阪大学様のもと評価方法に協力し、最適な治具・試験方法でばらつきの少ない方法で測定するノウハウを持っています。その他、パッケージシェア強度測定、ボール引張り強度測定、繰り返し曲げ試験や落下試験などデバイスメーカー様からの依頼にも対応できるよう基板作製、実装も行います。

- JIS Z 3198-5 : はんだ継ぎ手の引張りおよびせん断試験方法
- JIS Z 3198-6 : QFPリードのはんだ継ぎ手45度プル断試験方法
- JIS Z 3198-7 : チップ部品のはんだ継ぎ手せん断試験方法
実装基板環境評価試験
高温、低温、温度サイクル試験を行い、熱疲労による はんだの劣化を観察します。また、ウィスカ確認試験を 行うため恒温恒湿試験を行い、ウィスカの発生を走査型 電子顕微鏡(SEM)にて観察します。
ウィスカ評価試験
基板関連評価試験
リフロー試験・耐熱評価
耐熱評価での課題は、鉛フリー製品の接合で必要とな るリフロー温度が高い(最大値は260℃)ことです。これは、ボードに搭載される部品の全てが、鉛フリー・はんだの融点にさらされることでプラスチック製パッケージの場合、その大部分はJEDEC(Joint Electron Device Engineering Council)が規定する耐湿性レベル1および2において、こうした制約を満たすのは困難です。また、SOP(Small Outline Package)、TSSOP(Thin Shrink Small-Outline Package)などの小型パッケージが接合部の損傷、ポップコーン・クラック、反りなどの不具合現象を発生しています。これらの現象を確認するため耐熱評価としてリフローを行い、断面観察や超音波探査装置(SAT)で剥離を観察します。デバイスの超音波探査を行う場合は下記のように観察箇所を選定し、部品内部の剥離や亀裂の有無を観察します。また、観察した箇所は画像処理し、解りやすい報告をいたします。
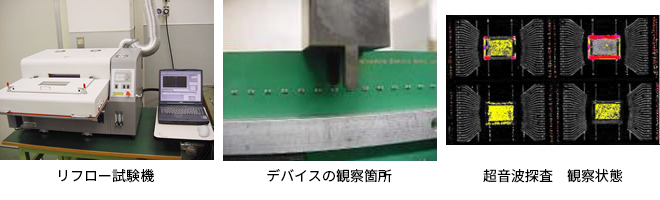
低銀鉛フリーはんだ実装評価
鉛フリーはんだの組成は銀3.0%(Sn-3.0Ag-0.5Cu:SAC305)が主流ですが、近年、貴金属である銀価格の高騰から銀の含有量を1.0%、0.3%、0.1%に減量した「低銀鉛フリーはんだ」が開発されています。実装の良否はペースト印刷時の各種パラメータ、実装プロファイル、基板のパターン設計等によって変化するため、はんだ変更時には信頼性試験を実施し、問題がないことを確認することが望まれます。ここでは、従来鉛フリーはんだ(3.0Ag)および低銀鉛フリーはんだ(1.0Ag、0.3Ag)を用いて各種電子部品を実装後、温度サイクル試験を実施し、はんだ接合強度により、はんだ種による接合信頼性の差異を評価した事例を紹介します。
評価事例
- はんだ種:3.0Ag、1.0Ag、0.3Ag
- 搭載部品:チップ抵抗(3216)
- 試験項目:温度サイクル試験 -40℃(30min)⇔+125℃(30min) 1500サイクル
- 測定項目:せん断強度
- 試験結果:試験サイクル数にともなって接合強度が低下する傾向が確認されましたが、はんだ種による明確な差異は確認されませんでした。
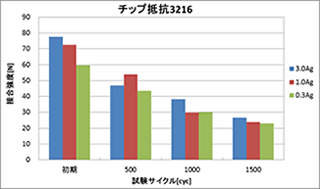
接合強度測定結果
OKIエンジニアリングの鉛フリー評価の実績データ
鉛フリーはんだ接合評価は微少領域の強度測定を行っているため、誤った測定方法で行うとばらつきが大きく、鉛フリーと共晶はんだの強度差が判らなくなります。当社では次のことを守り試験を行っています。
- 強度試験を行う際は、同じ治具を使用する。
- 試料固定後の微少な調整(移動)は、X-Yステージを使用する。
- ツール高さなどの設定は、ステンレスゲージを補助具として使用する。
- 作業マニュアルを作成し、教育を充実させる。
判定基準を適用するには定められた方法で行うことが重要であり、今後もデータ収集し、お客様に提案いたします。
- 鉛フリー実装評価のお問い合わせ先
- WEBからのお問い合わせ:お問い合わせフォームはこちら
電話:03-5920-2366






