- Home
- サービス一覧
- 解析(故障/良品)・観察・分析
- デキャップソリューション(樹脂開封)
解析(故障/良品)・観察・分析
デキャップソリューション(樹脂開封): 当社で長年、様々なパッケージ開封方法を試行・開発
デキャップソリューション(樹脂開封)
化学エッチングによる樹脂開封を支援する強力なレーザー加工ツールを導入し、ドライエッチングと化学エッチングの併用化により、高精度な樹脂開封が実現可能となりました。 パッケージの開封は、観察・故障解析・良品解析・分析などの様々な解析を行う上で重要な手法です。半導体デバイスの故障解析ではパッケージを除去した後にも電気的特性の状態を確認する事が多い為、組立構造を維持した状態で開封を行う半破壊解析が定石です。当社では長年、様々なパッケージ開封方法を試行・開発してきました。近年パッケージの微細化・複雑化に伴い開封の難易度が高まっておりますが、対象部品の種類や構造・材料から最適な開封方法を提案いたします。
ICおよびLSI用パッケージの歴史
メタルキャンタイプで1960年代に始まり、ガラスまたはセラミックシールのハーメチックタイプを経て'70年代以降はパッシベーション膜と封止樹脂の改良による長期信頼性の改善と共に、低価格と高い生産性を特徴とするプラスチックパッケージへと主流が移り変ってきました。その後、'80年代に入ってプラスチックパッケージの形態はリード挿入型パッケージから大幅な高密度実装化を可能とした表面実装型パッケージへと姿を変えながら現在に至っています。より一層高いコストパフォーマンスを要求されてるパッケージング技術ですが、品質を保持し設計段階での十分な信頼性検証のため、パッケージ内部のチップにストレスを与えない開封技術が必要になってます。
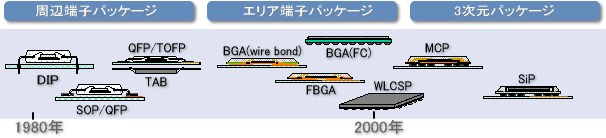
ICおよびLSI用パッケージの歴史
デキャップ(開缶・開封)作業
パッケージ開封作業について、樹脂開封後にICやLSIの機能特性を保持した状態での開封(開缶)をいたします。当社ではパッケージ構造を把握(X線検査等を併用)したパッケージ開封、樹脂開封作業が可能です。パッケージ開封時、内部のチップやワイヤーへのダメージを最小限に抑えた開封が可能です。半導体部品を構成する材料中には特定有害物質が含まれますので予備知識なしに分解・開封を行うと人体や環境に悪影響をおよぼすことがあります。完全な後処理を行える当社施設での解析を推奨いたします。
放射線試験・シングルイベント試験対応 デキャップ(開缶・開封)サービス
半導体デバイスに対して、放射線照射によるシングルイベント効果(SEE ;Singe Event Effects)の試験を行うに際しては、電気的特性を保った状態でデバイスパッケージを開封し、ICチップの表面を露出させる必要があります。
当社ではシングルイベント試験向けのデキャップサービスもご提供しており、これまでも高い動作率での開封実績があります。
また、当社サービスでは、以下に挙げる特長がございます。
- 基板実装状態でのデキャップが可能
- Cuワイヤ品のデキャップ対応
- 小サイズICのデキャップ対応
- 大量サンプルのデキャップオーダーに対応
- デキャップ後の半田実装対応が可能
これらの特長に関しては以下に詳細が記されている項目もございますので、そちらも併せてご覧ください。
プラスチック・パッケージの開封(樹脂開封)
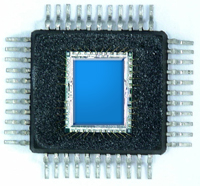
プラスチック・パッケージ
の樹脂開封例
- 標準パッケージ
(挿入実装型DIP・SIP・ZIP,表面実装型SOP・QFP・SOJ) - 加熱薬液滴下法によるチップ露呈・洗浄・アルコール置換
- 1個から開封可能。10個以内であれば即日開封・返却(出荷)
レーザー開封観察例
あらかじめX線透過画像等の内部画像データにより、加工エリア(加工形状、加工位置)を指定することが可能です。
- 例1)位置決め、モールド樹脂の除去
- 例2)チップ表面の直上までモールド樹脂の除去
- 例3)2ndワイヤーボンディング部の露呈
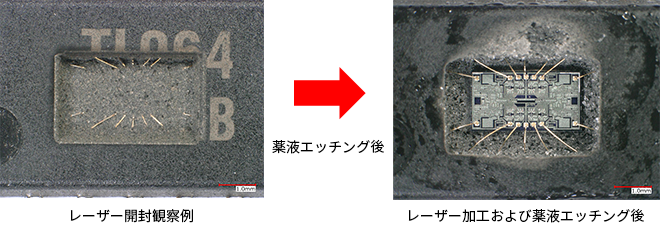
レーザー開封観察例をこちらでご覧いただけます。
電子回路基板に搭載したままの状態でのパッケージ開封が可能
電子機器・装置の故障解析においては、電子回路基板に搭載のLSIの故障が判明しても、そのLSI内部の故障箇所特定が必要となります。故障箇所特定には、装置の故障状態を維持するために、電子回路基板に搭載したままの状態でパッケージを開封して直接LSIを解析することが必要です。当社では、高精度レーザーパッケージ開封技術(※1)と薬液滴下開封技術(※2)を併用し、薬液の使用を減らすことで開封ダメージを低減し、電子回路基板に搭載したままでプリント基板やLSIを傷つけずにLSIのパッケージを開封することが可能です。
電子回路基板に搭載したままの状態でパッケージ開封する流れ
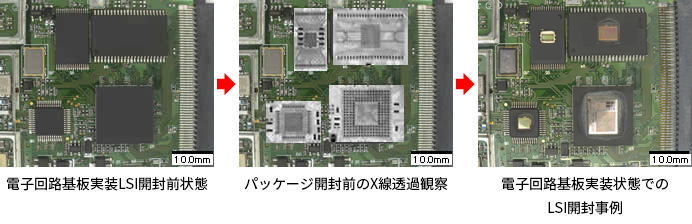
- ※1高精度レーザーパッケージ開封技術とは…レーザーを使って、IC、LSIなどのパッケージのモールドを開封(除去)する技術。レーザー加工時に試料像と透過X線像を重ねられるため、任意の領域を正確に加工できる。
- ※2薬液滴下開封技術とは…プラスチックパッケージLSIを開封するため、薬品(強酸)を滴下し、プラスチックを溶解、除去する方法。
デキャップソリューション(樹脂開封)解析例
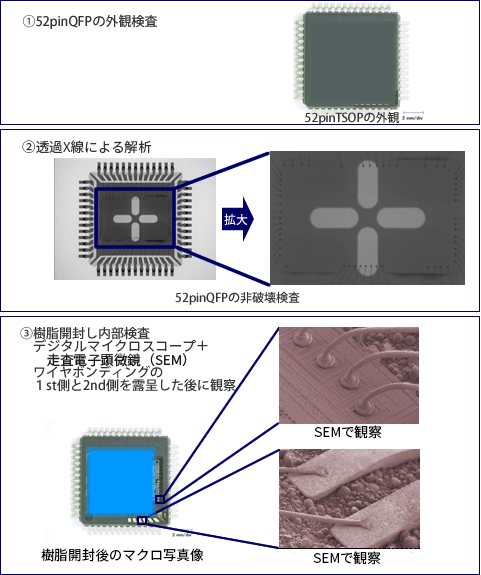
デキャップ(開缶・開封)方法の選択一覧
当社はレーザーと薬液の併用によるパッケージ開封が可能です。
| パッケージの種類 | 機械的手法 Mechanical |
化学処理 (薬液) Wet Etching |
非化学処理 Dry Etching |
|||
|---|---|---|---|---|---|---|
| Dropping | Jet | VPS/Boiling | LASER | RIE | ||
| アキシャル・リード | ○ | ○ | ○ | ○ | ○ | - |
| ラジアル・リード | ○ | ○ | ○ | ○ | ○ | - |
| メタル・キャン | ○ | - | - | - | - | - |
| セラミック・パッケージ | ○ | - | - | - | - | - |
| レジン・パッケージ | ○ | ○ | ○ | ○ | ○ | - |
| チップ | - | - | - | - | - | ○ |
設備仕様
| レーザーパッケージ開封装置 | ||
|---|---|---|
| 設備名 | 主な仕様 | 主な特徴 |
| レーザーパッケージ 開封装置 FA LIT |
出力:20W |
レーザーマイクロ加工による樹脂の局所剥離 2nd側ワイヤボンディング,Cu配線構造の露呈 短時間加工・低価格開封 |
- 解析(故障/良品)・観察・分析のお問い合わせ先
- WEBからのお問い合わせ:お問い合わせフォームはこちら
電話:03-5920-2366








