- Home
- サービス一覧
- 解析(故障/良品)・観察・分析
- Cuワイヤデバイスの解析技術
解析(故障/良品)・観察・分析
Cuワイヤデバイスの解析技術: Cuワイヤ品の半導体デバイスの信頼性評価、ならびに故障解析に際して重要となるパッケージ開封が可能
Cuワイヤデバイスの解析技術
近年、ボンディングワイヤはAu(金)ワイヤに換わり低コストなCu(銅)ワイヤやPd(パラジウム)被膜Cuワイヤによるボンディング技術の開発が進み、市場にもCuワイヤを使用した半導体デバイスが普及しはじめています。OKIエンジニアリングでは、Cuワイヤ品の半導体デバイスの信頼性評価、ならびに故障解析に際して重要となるパッケージ開封が可能です。ワイヤプル試験等、Cuワイヤ品の信頼性評価が必要なお客様への新たなソリューションとしてCuワイヤデバイスの解析技術をご提供いたします。
- Cuワイヤとは…IC、LSIなどの中の構造で半導体チップとリードフレームとの間を繋ぐ細い金属線(ボンディングワイヤ)にCuを使用しているもの
- ボンディングワイヤとは…IC、LSIなどの中の構造で半導体チップとリードフレームとの間を繋ぐ細い金属線のこと
Cuワイヤ品の信頼性評価が必要なお客様への新たなソリューション
- Cuワイヤデバイスに特化した開封法を用いて、Cuデバイスの信頼性評価、故障解析が可能
- イオンエッチングのみによる断面加工を行うことで信頼性試験前後での界面状態変化を捉えることが可能
- Cuワイヤデバイスの普及に拍車がかかることが充分に予測されるため、新規にCuワイヤデバイスを採用する場合の信頼性評価
Cuワイヤ品の信頼性試験、故障解析の特徴
最初にCuワイヤか判別するために、ワイヤ種別の識別方法(蛍光X線分析)を行い、次にCuワイヤに特化した手法で開封(通電可能な状態でチップ面を健全に露呈)します。各種信頼性試験(飽和加圧蒸気試験(PCT)、温度サイクル試験(TC)等)を行い、その後試料を開封し、Cuワイヤ品の導通試験、ワイヤループ形状、ワイヤプル試験、ボンディング接続部の断面観察等を実施することが可能です。

Cuワイヤ解析技術の位置づけ
ワイヤ種別の識別方法(蛍光X線分析)
使用しているワイヤ材の種別を公表しているメーカーは稀であり、またパッケージの外観から使用しているワイヤ材を識別することは不可能です。非破壊で、使用されているワイヤ材を特定する手法として、蛍光X線分析による分析が有効です。 透過X線での観察でもAuワイヤとCuワイヤでは材質差によるコントラスト差が生じるため、同一形状パッケージ品を並べた場合、判別は容易ですがパッケージ構造やワイヤ径が異なると見え方が変化するため、比較品がない場合、判断は難しいものとなります。

蛍光X線分析によるCuワイヤ品とAuワイヤ品の分析結果
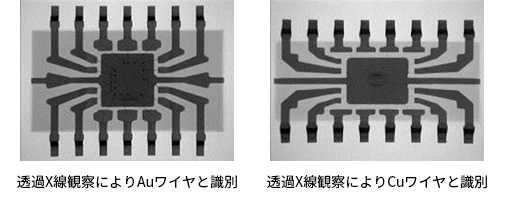
蛍光X線分析ではAuワイヤ、Cuワイヤ、Pd-Cuワイヤとも特徴元素成分の検出の有無で、パッケージ内部のワイヤ材料が非破壊で容易に同定可能です。
Cuワイヤ品の開封技術
パッケージ開封の目的・方法
パッケージ開封を行う目的は、下記の3つに大別されます。ここで最も高い難易度が要求されるのが、3のパッケージ内部組み立て構造や、Cuワイヤのボンディング品質評価であり、チップ面の開口およびCuワイヤのセカンドパッド部までの全面開口が必要とされ、さらに開封後のCuワイヤは可能な限り健全であることが要求されます。 当社ではAuワイヤ品のパッケージ開封として一般的な開封の状態を確認しながら進行できる薬液滴下法の各種条件(加熱温度、混酸比率、添加剤等)を詳細に検証し、内部組み立て構造やCuワイヤのボンディング品質評価を可能とする開封を、高確率で再現性よく得ることが可能です。特にCuワイヤとセカンドパッド部の銀メッキを良好な状態で、開封いたします。
パッケージ開封目的
- パッケージ内部のチップ取り出しやチップの観察、解析
- 故障解析や耐放射線試験等
- パッケージ内部組み立て構造や、Cuワイヤのボンディング品質評価
薬液滴下法による開封手順
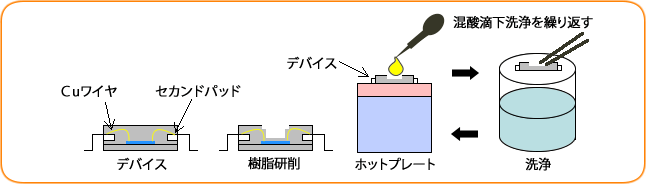
薬液滴下法による開封手順
- セカンドパッド部とは…IC、LSIなどの中の構造で、ボンディングワイヤをリードフレームに接続する部分。リード電極のこと。
Cuワイヤの開封実施例
従来の手順によるCuワイヤ開封実施例
Cuワイヤ薬液滴下法によるAuワイヤ対応(従来の)開封実施例です。マクロ写真像や、走査型電子顕微鏡像からわかるようにCuワイヤへのダメージが確認されました。
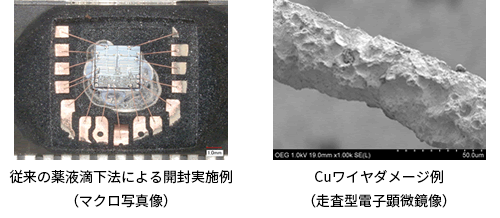
当社開発によるCuワイヤ開封実施例
当社が開発した、Cuワイヤ薬液滴下法によるCuワイヤ開封実施例です。マクロ写真像や、走査型電子顕微鏡像からわかるように健全性が確認されました。
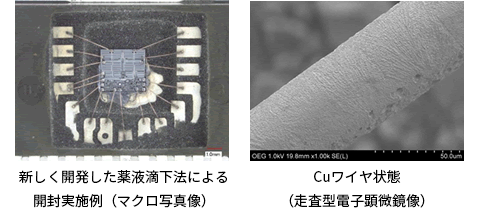
加速試験前後のボンドプル強度評価例
Cuワイヤとセカンドパッド部銀メッキを良好な状態に保ち、開封可能となったことで加速試験前後でのボンドプル評価が可能です。
温度サイクル試験(TC)500cycでは、未試験品よりわずかに接続強度が低下し、プレッシャクッカ試験(PCT)500Hでは、はっきりと接続強度が低下している事がわかります。最多破壊点は(D)でしたが、(B)部での破壊もあったことから信頼性試験により接続界面の腐蝕が進行している可能性があると考えられます。
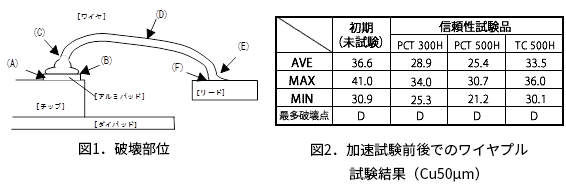
Cuワイヤ品の断面構造評価
微細な界面状態の変化を読み取ることは困難です。そこであらかじめ断面イオンポリッシング加工に適した形に加工(パッケージ表面を研磨除去)し、イオンポリッシングにより観察断面を作製しました。これにより信頼性試験前後での界面状態変化を捉えることが可能となります。
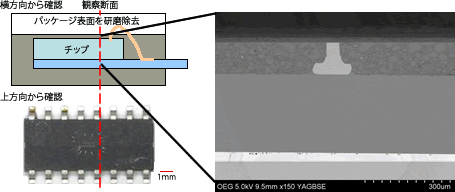
ボンディング接合部の状態観察をするための観察断面の作成法
ボンディング接合部の状態のSEM観察例(合金層状態の評価)
プレッシャクッカ試験(PCT)試験実施前のSEM観察ではみられなかった境界面部の酸化や合金層の成長、ボイド増加が確認されます。また、Cu球外周から内部に界面酸化が進行する様子も確認されます。
Cuワイヤ プレッシャクッカ試験(PCT)実施前 SEM観察
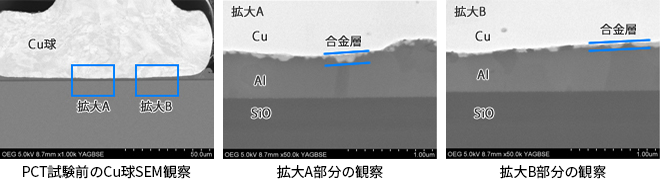
Cuワイヤ プレッシャクッカ試験(PCT120℃、500H)実施後 SEM観察
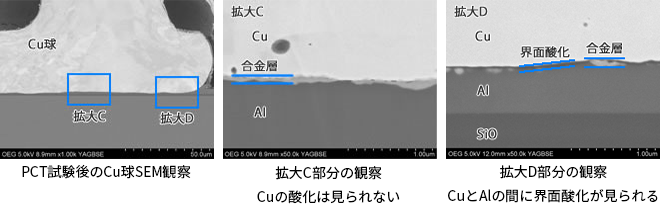
Cuワイヤ プレッシャクッカ試験(PCT120℃、500H)実施後の元素分布図
[エネルギー分散型X線分光法(SEMーEDX分析)例]
下図はボンディング接合部断面のSEM像およびSEM-EDX分析による元素分布です。界面部のボイドや酸化層が観察されます。
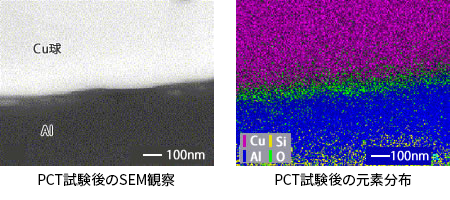
- 解析(故障/良品)・観察・分析のお問い合わせ先
- WEBからのお問い合わせ:お問い合わせフォームはこちら
電話:03-5920-2366








