- Home
- サービス一覧
- 解析(故障/良品)・観察・分析
- LSIプロセス診断
解析(故障/良品)・観察・分析
LSIプロセス診断: 非破壊で半導体パッケージ、セラミック、金属、樹脂部品などの内部ボイド、クラック、剥離などの欠陥を検出することが可能
LSIプロセス診断
LSIプロセス診断とは
宇宙機に使用される部品の品質評価指標として、宇宙開発事業団[現、国立研究開発法人宇宙航空研究開発機構(JAXA)]と当社が共同で構築したLSIの品質・信頼性確認技術です。現在では、宇宙部品に加え、高い信頼性が求められる車載部品や民生部品にも幅広く活用されています。
LSIプロセス診断は電気的に良品とされるデバイスを対象に、アセンブリプロセスおよびウェーハプロセスに着目した詳細な解析を行い、将来、故障の要因となりうる内在的な欠陥や不具合構造を特定し、故障にいたる危険性の推測・品質の評価を行うことが可能です。

LSIプロセス診断の判定基準
当社では外観検査、X線検査[透過、CT]、超音波探傷検査、内部検査、チップ表面検査、クレータリング検査、パッケージ断面検査、断面SEM検査、断面TEM検査、界層解析検査の検査項目を用いて、LSIプロセス診断を実施しています。各検査で得られたデータは、LSIプロセス診断評価項目に基づいて、項目ごとに定めた詳細な診断基準に従い評価・採点を行います。
評価項目には工程ごとに具体的な欠陥例が記述され、検査で検出された不具合構造と照合することで、定量的な評価と採点が可能です。診断基準は、当社がこれまでに行ったデバイスの故障解析・良品解析事例や各種文献を基に策定されています。さらに、LSIプロセス診断と信頼性試験との相互検証も実施しており、短期の信頼性試験や電気的特性検査では検出不可能な故障にいたる潜在的欠陥を検出し、LSIプロセス診断法の有効性が確認されています。なお、診断基準はプロセスの変遷や未知の欠陥検出に対応するため、随時見直し・更新を行っています。
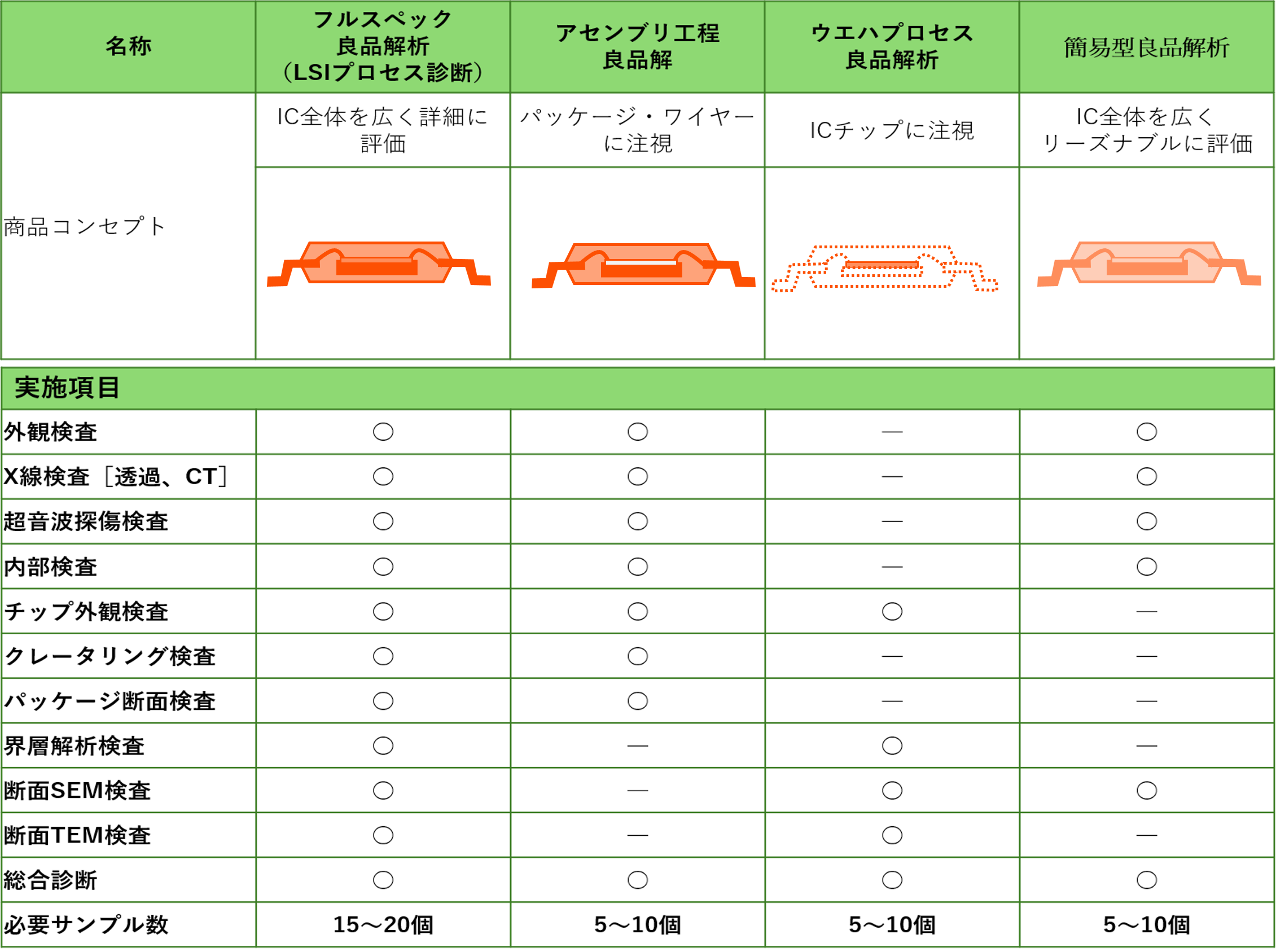
LSIプロセス診断例
この他にも検査実施項目はお客様のご要望にあわせてカスタマイズします。
お気軽にご相談ください。
よくあるご質問(FAQ)
- LSIプロセス診断とは何ですか?
市場故障などのトラブルを未然に防ぐために、デバイスの構造解析を通じて将来の故障要因になり得る「潜在リスク」を可視化・評価する診断手法です。電気的には良品のデバイスを対象に、将来の故障要因になり得る構造的な不具合の有無を評価します。
- 信頼性試験ではなく、なぜLSIプロセス診断を行うのですか?
信頼性試験は有効ですが、試験費用・サンプル購入費用・期間がかかるため、部品選定の段階では現実的に実施しにくいことがあります。プロセス診断は、比較的少量のサンプルで品質確認が可能です。
- LSIプロセス診断で分かることは何ですか?
信頼性試験や電気特性検査だけでは見つけにくい、潜在的な構造起因リスク(例:配線/絶縁膜/ビア周りの異常、膜厚・形状のばらつき等)を観察・解析し、故障につながる可能性や注意点を整理できます。
- どんな場面で役立ちますか?
部品選定時の比較検討、信頼性試験の前段での構造把握、量産採用前の品質確認、市場故障の予防・再発防止に役立ちます。
ご依頼の流れ
1:お問い合わせ
お問い合わせフォームから、ご依頼内容、サンプル情報、実施希望時期等についてお知らせください。
2:お問い合わせへのご回答とヒアリング・お見積り
OKIエンジニアリングの担当者より、お問い合わせ、ご依頼の詳細をヒアリングさせていただきます。ヒアリング中に解析内容のご確認、解析の可否、その他ご要望等を確認し、お見積りと納期を確認の上、ご連絡いたします。
3:ご依頼の発注と解析サンプルの送付
お客様より、ご依頼の注文書を送付いただきます。注文書受領後に、解析作業を開始します。解析サンプルの送付先は、OKIエンジニアリングの担当者よりご連絡します。
4:解析作業開始
ご依頼の解析を実施します。解析途中での中間報告のご対応も可能です。解析結果により、追加の解析や内容の変更をご提案する場合があります。
5:解析結果のご報告
解析結果を報告書にまとめ、お客様へ送付します。結果についてのご不明点や、ご質問などがあった際は、お気軽にご質問ください。
6:お支払い処理と解析サンプルのご返却
お客様にて報告内容のご確認後に、OKIエンジニアリングより解析サンプルと請求書・受領書・納品書を送付します。お支払い処理のご対応をお願いいたします。
- 解析(故障/良品)・観察・分析のお問い合わせ先
- WEBからのお問い合わせ:お問い合わせフォームはこちら
電話:03-5920-2366
検査一覧
- 外観検査
外観検査は目視およびOM(光学顕微鏡)によるパッケージおよびリードなどのデバイスの外観表面の検査を行います。 - 観察装置:実体顕微鏡、OM
- 検査対象:パッケージ、リード
- 検出される欠陥要因:変色,クラック,ボイド,異物の存在など
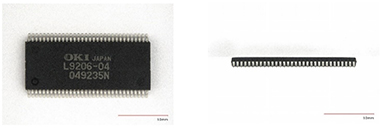
- X線検査
X線検査はX線装置によるデバイス内部の組立構造を検査します。 - 観察装置:マイクロフォーカスX線CT装置(X線CT)、マイクロフォーカス透過X線(透過X線)装置
- 検査対象:パッケージ内部構造、チップ接続、ワイヤ状態
- 検出される欠陥要因:クラック、ボイド、異物、ワイヤ流れなど
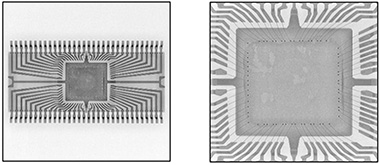
- 超音波探傷検査(SAT)
超音波探傷検査は超音波探査映像装置によるデバイス内部の異種材料間の各接合境界面の反射エコー波形観測および超音波音響画像を取得します。 - 観察装置:超音波探査映像装置
- 検査対象:異種材料間の接合境界面(モールド樹脂対チップ境界面等)
- 検出される欠陥要因:ボイド、クラック、剥離など
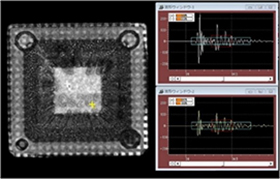
- 内部検査
内部検査はOM(光学顕微鏡)およびSEM(走査型電子顕微鏡)にて観察可能な内部全体、チップ搭載状態等の検査を実施します。 - 観察装置:OM、SEM
- 検査対象:内部接続(ワイヤ等)、チップ状態、ダイシング状態等
- 検出される欠陥要因:接続不良、クラック、異物など
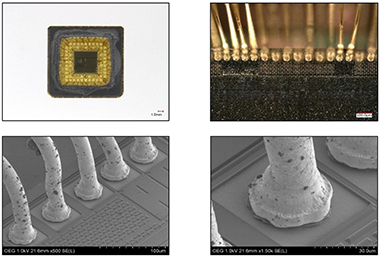
- チップ表面検査
チップ表面検査はOM(光学顕微鏡)を用いてパッシベーション膜と内部メタライゼーションを観察し、チップ全体像および特定部位を検査します。 - 観察装置:OM
- 検査対象:ロゴマーク,パッド,パッシベーション膜,メタライゼーション
- 検出される欠陥要因:クラック、ボイド、スクラッチ、異物など

- クレータリング検査(パッシベーションの健全性評価)
クレータリング検査はOM(光学顕微鏡)およびSEM(走査型電子顕微鏡)にてパッド下層部(パッド部下層バリアメタル、シリコン酸化膜面)の状態を検査します。あわせてOM(光学顕微鏡)にてパッシベーション膜の状態も検査します。 - 観察装置:OM、SEM
- 検査対象:パッド下層、パッシベーション膜
- 検出される欠陥要因:パッド下層・・・クレータリングの有無
パッシベーション膜・・・ピンホール、クラックの有無
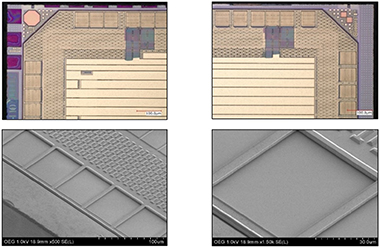
- パッケージ断面検査
パッケージ断面は樹脂埋め込みした試料に対して、断面加工(鏡面研磨)にて対象の内部構造をOM(光学顕微鏡)およびSEM(走査型電子顕微鏡)で検査します。 - 観察装置:OM、SEM
- 検査対象:パッケージ、フレーム、リード、ボンディング部
- 検出される欠陥要因:剥離、ボイド、クラック、接続不良など
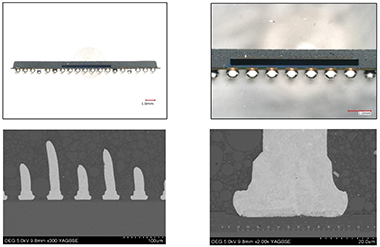
- 断面SEM検査
断面SEM検査はSEM(走査型電子顕微鏡)にて、チップの適切な代表回路を精密切断研磨法で断面加工し、積層膜を検査します。 - 観察装置:SEM
- 検査対象:保護膜、絶縁膜、メタライゼーション、接続構造、Si基板、素子分離、チャネル構造
- 検出される欠陥要因:形成不良、形状異常、ボイド、クラックなど
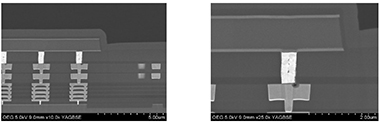
- 断面TEM検査
断面TEM検査はTEM(透過型電子顕微鏡)にて、チップの適切な代表回路をイオンミリング法で断面加工し、積層膜を検査します。 - 観察装置:TEM
- 検査対象:保護膜、絶縁膜、メタライゼーション、接続構造、Si基板、素子分離、チャネル構造
- 検出される欠陥要因:形成不良、形状異常、ボイド、クラック、結晶欠陥など

界層解析検査
- 界層解析検査
界層解析検査はSEM(走査型電子顕微鏡)にてパッシベーション膜、メタライゼーション膜、シリコン基板の各層表面を検査します。 - 観察装置:SEM
- 検査対象:パッシベーション膜、メタライゼーション膜、素子分離、Si基板
- 検出される欠陥要因:形成不良、形状異常、ボイド、クラック、結晶欠陥など
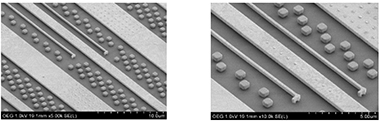
- 解析(故障/良品)・観察・分析のお問い合わせ先
- WEBからのお問い合わせ:お問い合わせフォームはこちら
電話:03-5920-2366









