- Home
- サービス一覧
- 解析(故障/良品)・観察・分析
- LSI構造情報取得サービス
解析(故障/良品)・観察・分析
LSI構造情報取得サービス: 構造情報のデータをご提供
LSI構造情報取得サービスFloTHERM ®をはじめとする熱流体解析ソフトに使用するパラメータ取得(ICやLSIのパッケージ構造の解析、観察、測定)を行います
OKIエンジニアリングでは各種電子部品、ICやLSIにおけるパッケージ内の構造を正確に観察・解析・測定をし、チップ、リード、ダイパッド、モールド樹脂の各種寸法や厚さなどの構造情報のデータをご提供いたします。この構造情報データは、電子機器の熱設計に使用する熱流体解析ソフトやパッケージのシミュレーションモデル構築に有効です。
LSI構造情報取得サービス
下記のLSIやICの構造情報が取得可能です。さらに詳細な組成情報の元素分析も可能です。
- パッケージ名称(PGA、DIP、SOP、SOL、QFP、SSOP、LQFP、TSOP、TQFP、LCC、QFN、WLP、DTP、QTP、BGA、FPGA、EBGA、FCBGA等)や特徴
- チップの寸法、モールド樹脂の厚さ
- パッケージボディの骨格材料(プラスチック基板、セラミック基板、TAB テープなど)
- リードピッチの長さ
- キャップの種類(セラミック、メタル)
- リードフレーム材料(Cu、Fe系など)
- 封止材料成分(フィラ―成分、樹脂成分)
- 半導体素子と導電性材料を電気的に接続するワイヤーの種類(Au、Ag、Al、Cuなど)
- 端子の種類
X線検査装置によるリードフレーム構造情報の取得
X線検査装置を使用し、半導体パッケージ上方および側方を撮影し、全体構造を判断します。
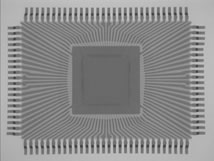
X線観察像により内部フレーム構造を確認
断面研磨加工処理・光学顕微鏡観察による厚さ情報の取得
半導体パッケージ中央部を切断し、断面研磨加工処理をし、光学顕微鏡観察から各部の寸法を測定します。
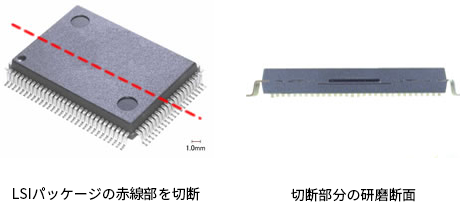
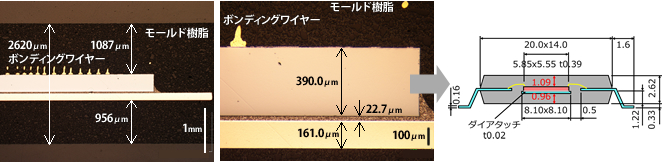
光学顕微鏡観察による寸法情報の取得
モールド樹脂開封・光学顕微鏡によるチップ寸法情報の取得
必要に応じてモールド樹脂を除去(開封)し、内部構造解析、観察や内部の部材を取り出す事も可能です。

モールド樹脂開封による構造情報(チップ寸法)取得
- 解析(故障/良品)・観察・分析のお問い合わせ先
- WEBからのお問い合わせ:お問い合わせフォームはこちら
電話:03-5920-2366








