環境システム技術
排ガス処理システム、設置、保守
半導体製造・液晶ディスプレイ製造・太陽電池(PV)製造をする際に、クリーニングやエッチングなどの工程で使用されるPFC類等は、温暖化係数の高いガスです。OKIエンジニアリングでは、排ガス中の有害物質(シラン、TEOS、PFC、F等)を、除外する排ガス処理システム、湿式排ガス処理装置(※1)、の設置、保守をご提供します。お客様のニーズにお応えし、環境システムのカスタム設計を行います。半導体製造・液晶ディスプレイ製造・太陽電池(PV)製造に使用される、特殊材料ガス除去対応により、温室効果ガスの削減による環境対策と安全性の向上、メンテナンス軽減に有効です。
各業種で使用するガス種とその排ガス処理方法
半導体製造、液晶ディスプレイ製造、太陽電池(PV)製造ともに下記の表にありますようにそれぞれ各業種とも、使用するガス種が似ています。生産装置台数が多い民生用の太陽電池製造では、まとめて大流量処理できる燃焼式除害装置+ 湿式排ガス処理装置もしくは、湿式排ガス処理装置が主流となり、当社でも湿式排ガス処理装置で、ガス処理をして無害化にするご提案をいたします。
- ※1湿式排ガス処理装置は酸性有害ガスや水銀等重量金属類の除去に極めて優れています。
- 納入実績
- 湿式排ガス処理装置の納入実績は、国内外合わせて200台以上
- 大陽日酸社製・燃焼式除害装置との組み合わせで100台以上

主な排ガス処理方法
使用するガス量は半導体製造は少流用ですが、液晶製造、太陽電池(PV)製造で使用されるガス種は大流量になってます。
半導体製造で使用されるガス種
半導体製造で使用されるガス種は半導体製造プロセスで多く用いられ、チャンバ内に堆積した不純物質を除去するクリーニングガスや、微細パターンを形成するためのエッチングガスに使用されています。
| 製造工程 | 使用ガス種 |
|---|---|
| 成膜 | シラン(SiH4)、ジクロロシラン(SiH2Cl2)、ジボラン(B2H6)、ホスフィン(PH3)、 アンモニア(NH3)、亜酸化窒素(N2O)、六フッ化タングステン(WF6)など |
| エッチング | 四フッ化シラン(SiF4)、塩化水素(HCl)、臭化水素(HBr)、 四フッ化メタン(CF4)、六フッ化硫黄(SF6)、三塩化ホウ素(BCl3)など |
| クリーニング | 四フッ化メタン(CF4)、六フッ化エタン(C2F6)、三フッ化窒素(NF3)、 フッ素ガス(F2)、フッ化水素(HF)、フッ化カルボニル(COF2)など |
| エピタキシャル | ジクロロシラン(SiH2Cl2)、塩化水素・H2ベース(HCl/H2) |
液晶ディスプレイ製造で使用されるガス種
液晶ディスプレイの製造工程で現在使用される温室効果ガスは、化学気相成長(CVD)クリーニングガスやパターニング用エッチングなどの工程で使用される温暖化係数の高いガスです。
| 製造工程 | 使用ガス種 |
|---|---|
| 成膜 | シラン(SiH4)、アンモニア(NH3)など |
| エッチング | 塩素ガス(Cl2)、四フッ化メタン(CF4)、六フッ化硫黄(SF6)、 三塩化ホウ素(BCl3)など |
| クリーニング | 四フッ化メタン(CF4)、六フッ化エタン(C2F6)、三フッ化窒素(NF3)、 フッ素ガス(F2)、フッ化水素(HF)、フッ化カルボニル(COF2)など |
太陽電池(PV)製造で使用されるガス種
太陽電池(PV)の製造工程においても様々なガスが使用されます。太陽電池製造過程で発生する温暖化ガスは、PFCですが、おもに太陽電池に使用される半導体のクリーニング等に使用されます。
| 太陽電池の種類 | 使用ガス種 | 用途 | ||
|---|---|---|---|---|
| シリコン系 | 結晶系 | 単結晶シリコン | シラン(SiH4)、アンモニア(NH3)、 水素(H2) 、クリーニングPFCガス など |
宇宙用 電力用 |
| 多結晶シリコン | 電力用 | |||
| 非結晶系 | アモルファスシリコン (薄膜) |
シラン(SiH4)、ジボラン(B2H6)、 ホスフィン(PH3)、ゲルマン(GeH4)、 クリーニングPFCガス など |
民生用 | |
| 化合物系 | 単結晶系 | GaAsなど | アルシン(AsH3)、トリメチルガリウム(TMG)、 トリメチルインジウム(TMI)、 クリーニングPFCガス など |
宇宙用 |
| 多結晶系 | CIS、CIGSなど | セレン化水素(H2Se)、硫化水素(H2S)、 クリーニングPFCガス など |
民生用 | |
地球温暖化係数(GWP)とは
地球温暖化係数(GWP)とは二酸化炭素(CO2)を基準に1としたとき、その気体が大気中における100年間の温室効果が地球温暖化に与える影響の相対係数です。半導体製造、液晶製造、太陽電池(PV)製造のクリーニングで使用されるCF4、C2F6、NF3などのPFCガスは温暖化係数が高く、地球温暖化対策としてF2、HF、COF2やClF3などの係数の低いガスに移行しています。

導入事例

成膜系、エッチング系、クリーニング系等の各種半導体材料ガスおよび特殊ガスを湿式にて除害処理するスクラバーです。高負荷、大流量プロセス排気として100slm単位、キャリア含め1000slm単位まで処理実績があります。
太陽電池(PV)製造向け排ガス処理例
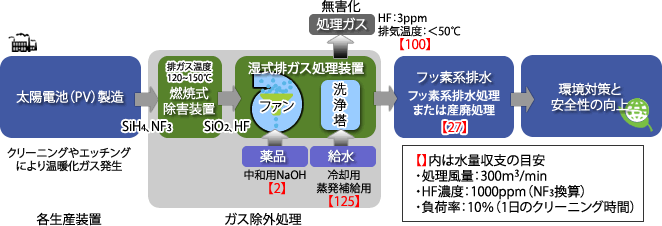
排ガス処理 装置一覧
| 設備種類 | 方式名称 | |
|---|---|---|
| 常圧CVD装置 (APCVD) |
テトラエトキシシラン(TEOS) | 分離・吸収方式 |
| シラン(SiH4) | 横型湿式方式 | |
| エピタキシャル成膜装置 (Epitaxial) |
トリクロロシラン(TCS)、ジクロロシラン(DCS) | 高圧水洗方式 |
| ドーピング装置 (Doping) |
ホスフィン(PH3)、アルシン(AsH3) | 大風量吸着方式 |
- 排ガス処理システム、設置、保守に関するお問い合わせ先
- WEBからのお問い合わせ:お問い合わせフォームはこちら
電話:03-5920-2356 FAX:03-5920-2306








